유기박막 분석 [MALDI Application]
Ag SALDI 질량 분석 이미징 및 XPS를 사용한 깊이 프로파일링
개요
10차 이온 질량 분석법(SIMS)은 시료 표면의 유기 화합물을 관찰하는 데 사용되는 분석 기술입니다. SIMS를 MSI(질량 분석 이미징)에 사용하면 이온화된 분석 물질에 대한 높은 공간 분해능 이미지를 생성할 수 있습니다. 그러나 SIMS는 종종 모 화합물의 단편화로 인해 복잡한 질량 스펙트럼을 생성합니다. 이 단편화는 이온화에 사용되는 1차 이온 빔의 과도한 내부 에너지로 인해 발생합니다. 최근에는 MALDI(매트릭스 보조 레이저 탈착/이온화) 및 SALDI(표면 보조 레이저 탈착/이온화)와 같은 소프트 이온화 방법을 사용하는 MSI 기술을 사용하여 샘플 표면의 유기 화합물 분포를 보다 명확하게 보여주는 온전한 분자량 정보를 생성했습니다. . 이러한 기술은 유기 화합물 혼합물을 사용한 시료 표면 분석에 특히 유리합니다. MALDI-MSI의 경우 시료 표면에 매트릭스 용액을 분사하여 유기 화합물의 이온화 효율을 높입니다. 그러나 매트릭스 용액을 표면에 적용하면 다음과 같은 몇 가지 문제가 발생할 수 있습니다. (i) 용액으로 인해 대상 화합물이 이동하여 표면의 분포가 변경될 수 있고 (ii) 이온 강도가 매트릭스의 변화로 인해 변동될 수 있습니다. 결정 형성(수십 미크론). 결과적으로 실제 공간 분해능이 감소하고 프로빙 깊이를 결정하기 어렵습니다. 또는 Ag SALDI-MSI의 경우 은 나노 입자가 용매 없이 XNUMXnm 두께로 샘플 표면에 증착되므로(그림 XNUMX) 공간 분해능이 향상되고 프로빙 깊이 결정이 더 쉬워집니다.
이 보고서에서는 Ag SALDI-MSI의 프로빙 깊이를 모니터링하기 위해 두께가 다른 이중층 유기 박막을 만들었습니다. 또한 가스 클러스터 이온 빔(GCIB)과 결합된 X선 광전자 분광법(XPS)을 사용하여 동일한 샘플의 깊이 프로파일링을 수행했습니다.
질량 분석계: JMS-S3000 "SpiralTOF™"
JMS-S3000 "SpiralTOF™"(그림 2a)는 MALDI TOFMS(Time-of-Flight 질량 분석기)로, 2개의 정전기 섹터로 구성된 나선형 이온 궤적을 가지고 있습니다(그림 17b). SpiralTOF™의 총 이온 비행 경로 길이는 XNUMXm(기존 TOFMS보다 XNUMX배 더 길음)이므로 MALDI TOFMS 시스템에서 상업적으로 사용할 수 있는 가장 높은 질량 분해능을 달성할 수 있습니다. 또한 정전기 섹터에서 사후 소스 붕괴 이온을 제거하여 화학적 배경의 간섭을 줄입니다. 이러한 기능은 오염된 샘플 표면에서 작은 구성 요소를 감지하는 데 유리합니다.
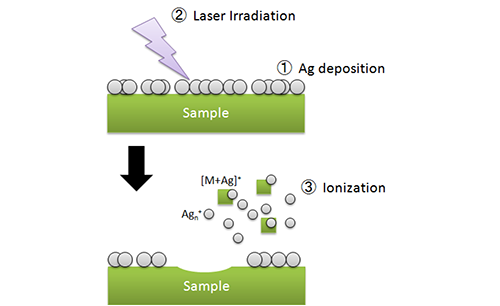
Fig.1 Ag SALDI의 원리.

그림 2 a) JMS-S3000 "SpiralTOF™" 및 b) 나선 이온 궤적.
X선 광전자 분광법: JPS-9030
JPS-9030은 샘플 표면의 원소 조성 및 화학 결합 상태를 분석하는 데 사용할 수 있는 XPS 시스템입니다(그림 3). X선이 시료 표면에 조사되어 다양한 표면 분석물에서 광전자를 생성합니다(그림 4). XPS와 GCIB를 결합하면 원소 조성 및 화학 결합 상태의 깊이 프로파일링이 가능합니다. 최근에는 이온 식각에 가스 클러스터 이온을 이용하여 쉽게 손상되는 유기 시료에 이러한 기술을 적용하고 있다.
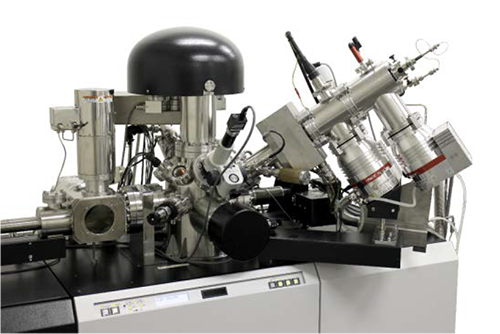
Fig.3 JPS-9030 X선 광전자 분광기.

Fig.4 X선 광전자 분광법의 원리.
샘플 준비: 이중층 필름
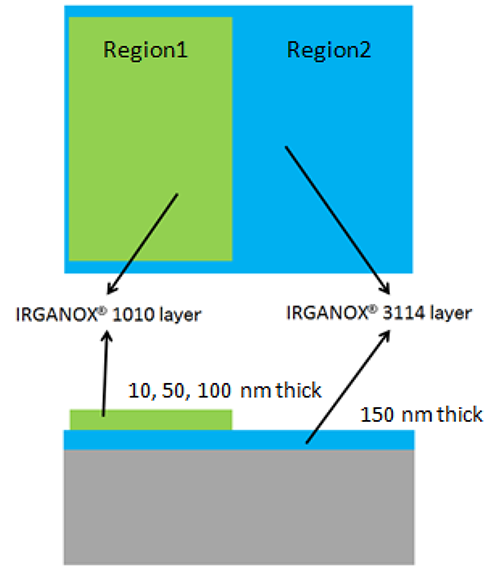
그림 5. 이중층 박막의 다이어그램
이중층 박막은 IRGANOX 1010(C73H108O12) 및 IRGANOX 3114(C48H69N3O6). 먼저, 150nm 두께의 IRGANOX 3114 층을 Si 웨이퍼 위에 증착했습니다. 다음으로, IRGANOX 1010은 IRGANOX 3114 필름의 절반에 10, 50 또는 100nm의 두께로 증착되었습니다. 이 이중층 필름 IRGANOX 1010/3114를 영역 1이라고 하고 IRGANOX 3114만 있는 영역을 영역 2라고 합니다(그림 5). 은은 1nm 두께로 영역 2과 10에 증착되었습니다. 그 후, FE SEM JSM-7610F(그림 6a)를 사용하여 샘플 표면의 은나노 입자를 관찰했습니다. 5kV의 가속 전압을 사용하여 6차 전자 이미지를 관찰했습니다(그림 20b). SEM 이미지에서 섬 모양의 회색 영역이 실제 은나노 입자입니다. 이 이미지는 나노 입자가 샘플 표면에 균일하게 분포되었음을 보여줍니다. SEM 이미지의 시야는 Ag SALDI-MSI 동안 사용되는 레이저 직경(XNUMXμm)보다 훨씬 작다는 점에 유의해야 합니다.
IRGANOX는 BASF SE의 등록 상표 또는 상표입니다.

그림 6. a) JSM-7610F 및 b) 샘플 표면에 증착된 Ag-NP의 SEM 이미지.
측정 조건
IRGANOX 1010/3114의 깊이 프로파일링은 GCIB와 함께 SALDI-MSI 및 XPS를 사용하여 수행되었습니다. 측정 조건은 다음과 같습니다. XPS 측정 동안 Ar 클러스터 이온 빔으로 에칭하여 IRGANOX 표면에서 Si 웨이퍼까지 10nm마다 스펙트럼을 획득했습니다.
표 1. SALDI-MSI 및 XPS의 측정 조건
| 살디-MSI | XPS |
|---|---|
|
JMS-S3000 스파이럴TOF™ |
JPS-9030 |
결과 및 토론
1. Ag SALDI-MSI
10, 50 및 100nm IRGANOX 1010 층에 대한 Ag SALDI-MSI 결과는 그림 7ac에 나와 있습니다. [M+Ag]에 대한 질량 이미지입니다.+ IRGANOX 1010 및 IRGANOX 3114의 영역 1 및 2에 대한 각 박막 경계는 IRGANOX 1010 질량 이미지에서 녹색(관찰됨) 및 검은색(관찰되지 않음)으로 표시됩니다. Ag SALDI-MSI에 대한 라인 프로파일은 그림 7a의 빨간색 점선을 따라 측정되었으며 그 결과는 그림 7d에 나와 있습니다. 라인 프로파일에 대한 상대 이온 강도는 영역 3114에서 평균 IRGANOX 2 강도로 정규화되었습니다. IRGANOX 3114 하부 층에 대한 강도는 상부 층 IRGANOX 1010의 두께가 증가함에 따라 감소했습니다. 마지막으로, 100nm IRGANOX 1010 층 아래에서는 이온이 검출되지 않았습니다. 따라서 Ag SALDI-MSI 측정을 위한 프로빙 깊이는 50~100nm였으며, 이는 XPS가 GCIB 없이 분석할 수 있는 것보다 더 깊습니다. 다음 섹션에서는 IRGANOX 1010(50nm)/3114 영역의 깊이 프로파일을 측정하기 위해 XPS를 GCIB와 결합했습니다.

그림 7. 은 첨가물 이온([M+Ag]의 질량 이미지+) Ag-NP SALDI-MSI(ac)를 사용하여 얻은 IRGANOX 1010/3114의 경우. IRGANOX 3114의 은 부가물 이온의 라인 프로파일도 표시됩니다(d).
2. XPS와 GCIB를 사용한 깊이 프로파일링
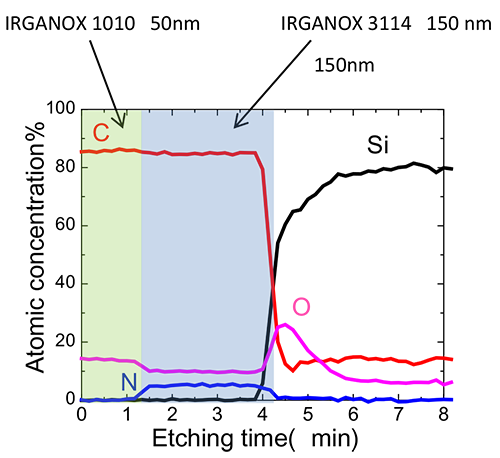
그림 8. 1010(50nm)/3114에 대한 깊이 프로파일링
(150nm) GCIB와 함께 XPS 사용.
IRGANOX 1010(50nm)/3114(150nm)의 깊이 프로파일을 결정하기 위해 XPS를 GCIB와 결합했습니다. 탄소, 질소, 산소 및 실리콘에 대한 원자 농도의 변화는 그림 8에 나와 있습니다. 실리콘의 원자 농도는 약 8분이 소요되는 Ar 클러스터 이온 에칭에 의한 유기층의 완전한 제거를 모니터링하는 데 사용되었습니다(참조: 그림 3114). 질소의 원자 농도는 IRGANOX 1010(질소 함유)와 IRGANOX 10(질소 없음)을 구별하는 데 사용되었습니다. XPS와 GCIB의 조합은 XNUMXnm 증분의 깊이 프로파일링에 사용되었으며 대상 레이어에 대한 원소 조성 비율의 차이를 모니터링했습니다.
이 10nm 깊이 분해능은 앞서 설명한 바와 같이 유기층에 대한 50nm 깊이에서만 평균 정보를 얻을 수 있는 Ag SALDI-MSI에 비해 이점을 제공합니다. 한편, 각 층의 원소 조성비가 최소한의 차이를 보인다면 표면에 존재하는 실제 분자를 식별하기 위해 Ag SALDI-MSI로 표면을 분석하는 것이 중요합니다.
결론
- Ag SALDI-MSI 및 XPS/GCIB를 사용하여 IRGANOX 1010에서 IRGANOX 3114의 이중층 박막을 관찰했습니다.
- Ag SALDI-MSI 측정을 위해 10nm 은 나노입자 층이 박막에 증착되었습니다.
- Ag SALDI-MSI의 프로빙 깊이는 50-100nm 사이로 결정되었습니다.
- GCIB와 결합된 XPS의 프로빙 깊이는 10nm로 결정되었습니다.
수신 통보
이중층 박막을 제공해 주신 교토 대학의 Matsuo 교수와 Fujii 박사에게 감사드립니다.
- 인쇄본을 보고 싶으시면,
이 PDF 파일을 클릭하십시오. 
PDF 897.8KB
