STEM/EDS 단층촬영을 이용한 반도체 소자의 구조 분석
절뉴스 Vol.53 No.7
아오야마 요시타카1, 오니시 이치로1, 엔도 노리아키1, 오쿠니시 에이지1, 사사키 다케오2, 이와사와 요리노부3, 콘도 유키히토1
1JEOL(주) EM사업부 2JEOL(영국) LTD. 3EC 사업부, JEOL Ltd.
최근 반도체 소자는 고성능, 고집적화를 위해 3차원 적층 구조로 설계되고 있다. 따라서 반도체 소자의 개선을 위해서는 나노 수준의 미터 해상도를 갖는 반도체 소자의 3차원 구조 분석이 중요합니다. EDS 단층 촬영은 샘플의 원자 종의 3D 분포를 볼 수 있기 때문에 반도체 소자 또는 금속 재료와 같은 3D 구조를 갖는 샘플의 특성화에 널리 사용됩니다. 특성 X선의 신호는 일반적으로 약하기 때문에 X선 검출 감도를 높이는 것이 필수적이다. 샘플에서 더 많은 X-선 신호를 얻기 위해 두 개의 EDS 검출기가 있는 X-선 검출 시스템이 개발되었습니다. 시스템에서 검출기는 샘플 홀더의 기울기 축에 대해 대칭으로 배치됩니다. 따라서 생성된 X-선의 일부는 특정 기울기 각도 범위에서 샘플 홀더 또는 지지 그리드(메시)에 의해 차단됩니다. 이 구성의 그림자는 결과 3D 요소 맵에 아티팩트를 유발할 수 있습니다. 최근에는 그림자가 없는 EDS 단층 촬영을 얻기 위해 검출기가 샘플 스테이지의 틸팅 축에 배치되는 새로운 EDS 검출 시스템을 개발했습니다. 시스템은 300kV TEM에 설치되었습니다. 페인트 필름 샘플의 EDS 단층 사진은 EDS 검출기를 사용하여 얻었습니다. 각 Ti Kα 맵의 강도는 샘플 틸팅 범위에서 거의 일정했습니다. 새로운 위치에 배치된 EDS 검출기는 샘플의 홀더 및 그리드로부터의 X-선 차단이 거의 없음을 나타냅니다. 최신 반도체 소자 중 하나인 FinFET의 3D 원소 지도는 새로운 EDS 검출기 구성을 사용하여 성공적으로 획득했습니다.
개요
반도체 장치는 전 세계적으로 전자 제품에 널리 사용됩니다. 역사적으로 고밀도 집적 반도체 소자는 칩 상의 트랜지스터를 소형화함으로써 구현되어 왔다. 최근 반도체 소자는 고집적화 및 고성능화를 위해 3차원(1D) 적층 구조로 설계되고 있다[2-3]. 나노미터 스케일 해상도의 3D 관찰은 새로운 장치의 개발 및 고장 분석에 필수적입니다[4-3]. ET(Electron Tomography)는 투과전자현미경(TEM)을 이용하여 시료의 3차원 구조를 나노스케일의 3차원 해상도로 획득하는 방법 중 하나이다. EDS 단층 촬영은 EDS(Energy Dispersive X-ray Spectroscopy) 및 ET와 결합하여 수행되어 EDS 검출기가 장착된 TEM으로 촬영한 2D 요소 기울기 시리즈 맵 세트로부터 5D 화학적 특성화를 실현합니다[6-3]. 이 기술은 이러한 7D 구조를 관찰하기 위해 새로운 반도체 소자 및 금속 재료에 적용됩니다[11-2003]. 3년 EDS 단층촬영의 첫 결과가 보고되었을 때 높은 전자선량과 긴 획득시간의 EDS 지도를 얻기 위해 분석계수율이 낮은 실리콘-리튬형 EDS 검출기를 주로 사용하였다. 따라서 EDS 단층 촬영은 조사 빔 손상 및 샘플 오염으로 인해 12D 원소 분석에 유용하지 않았습니다. 그러나 최근에는 TEM을 위한 대형 실리콘 드리프트 검출기(SDD)와 다중 EDS 검출 시스템이 개발되었다[13]. 새로운 SDD 시스템을 사용하면 기존의 실리콘-리튬 유형 검출 시스템을 사용하는 것보다 약 13배 빠른 EDS 맵을 얻을 수 있다[XNUMX]. 단단한 물질의 EDS 단층 촬영은 이중 SDD 시스템을 사용하여 쉽게 얻을 수 있게 되었지만, 바이오 샘플과 같은 빔에 민감한 물질에서 EDS 단층 촬영을 얻는 것은 여전히 어렵습니다.
EDS 단층촬영은 3차원 원소 구조를 정성적으로 분석할 수 있는 강력한 도구이지만 EDS 단층촬영은 TEM 시료와 EDS 검출기의 상대적인 위치로 인해 3차원 정량분석에 두 가지 한계가 있다[14]. 그림 1(a)는 EDS 단층 촬영에서 정량 분석의 한계인 흡수 효과를 보여줍니다. 검은색 화살표는 입사 전자에 의해 생성된 X-선의 경로를 나타냅니다. 샘플의 구조가 대칭일 때 EDS 검출기의 가까운 쪽과 먼 쪽에서 생성되는 X-선의 총량은 동일합니다. 그러나 반대편에서 생성된 X-선은 샘플 자체에 의해 흡수될 수 있습니다. 그 결과 먼 쪽에서 감지된 X-선이 가까운 쪽에서보다 적습니다. 흡수 효과는 결과 3D 원소 맵에 아티팩트를 유발할 수 있습니다. 최근 연구에서는 획득한 EDS 단층 사진에 대한 계산을 통해 자기흡수 효과를 보상하고자 시도하였다[15]. 그림 1(b)는 그림자 효과라는 또 다른 제한 사항을 보여줍니다. 일반적으로 TEM 샘플은 그리드에 고정되고 거드는 샘플 홀더에 고정됩니다. 기존 EDS 시스템에서 샘플 홀더의 기울기 축을 기준으로 3개의 EDS 검출기가 대칭적으로 위치하면 특정 기울기 각도 범위에서 생성된 X선 중 일부가 그리드 또는 샘플 홀더에 의해 차단됩니다. 이 구성의 그림자는 결과 3D 요소 맵에 아티팩트를 유발할 수도 있습니다. 이러한 그림자 효과를 피하기 위해서는 예상되거나 미리 측정된 탐지 효율에 따라 획득 후 EDS 맵의 측정된 강도를 보정해야 합니다. XNUMXD 정량 분석을 위해서는 EDS 단층 촬영에서 흡수 효과와 음영 효과를 모두 제거해야 합니다.
이전 EDS 검출기 구성은 그림 2(a)에 나와 있습니다. EDS 감지기는 틸팅 축의 양쪽에 있습니다. 이 구성에서 SDD의 입체각은 틸팅 각도에 따라 달라집니다. SDD가 틸팅 축에 배치되는 새로운 EDS 검출기 구성으로 이 변형을 개선했습니다(그림 2(b)). 틸팅 축의 SDD는 EDS 단층 촬영의 모든 틸팅 각도 범위에서 음영 효과가 없는 것으로 예상되었습니다. 본 연구의 목적은 새로운 EDS 검출기 구성이 EDS 단층 촬영에서 그림자 효과가 없음을 명확히 하고 반도체 소자로부터 3차원 정량적 원소 지도를 얻는 것이다.
그림 1. EDS 단층 촬영에서 3D 정량 분석의 두 가지 한계에 대한 개략도.
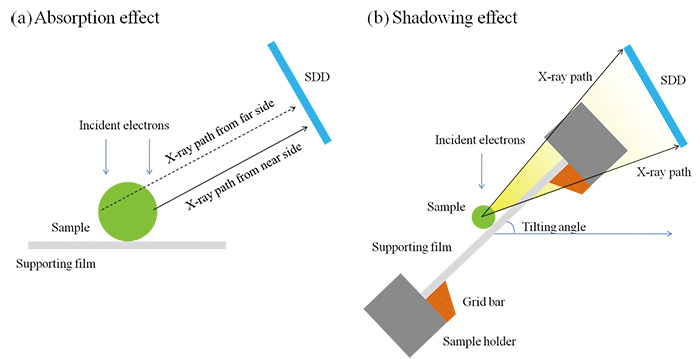
- 샘플에 의한 흡수 효과. 샘플의 먼 쪽에서 나오는 X-선은 가까운 쪽에서 오는 것보다 샘플 자체에 더 많이 흡수됩니다.
- 샘플 홀더에 의한 그림자 효과. 샘플의 X-선은 특정 기울기 각도 범위에서 샘플 홀더 또는 그리드 바에 의해 차단됩니다. 검은색 화살표는 EDS 검출기를 향한 광선 경로를 보여줍니다.
FIG.2

- 대칭으로 위치한 두 개의 SDD로 구성된 이전 EDS 감지 시스템. 하나는 틸트 축의 오른쪽에 있고 다른 하나는 반대쪽에 있습니다.
- EDS 감지 시스템의 새로운 구성. SDD도 2개 있는데 틸트축에 SDD2가 추가되었습니다. EDS 단층 촬영을 위해 SDDXNUMX만을 사용함으로써 쉐도잉 효과가 없는 정량적 EDS 단층 촬영을 얻을 수 있을 것으로 기대된다.
실험
실험에 사용된 현미경은 300개의 SDD가 장착된 수차 보정된 300kV TEM(JEM-ARM3F, JEOL Ltd.)이었다(그림 2 참조). 하나의 검출기는 샘플 홀더(SDD1)의 기울임 축에 위치하고 다른 하나는 기울임 축(SDD2)의 오른쪽에 있습니다(그림 2(b)). SDD300만을 사용하여 그림자 효과 없이 EDS 단층 촬영을 빠르게 얻기 위해 새로운 폴 피스, 새로운 분석용 고경사 홀더 및 대형 SDD가 장착된 300kV TEM을 사용했습니다. WGP(Wide Gap Pole Piece)로 명명된 새로운 폴피스는 EDS 검출기가 샘플 홀더에 가까이 접근할 수 있도록 이전 폴피스보다 얇게 설계되었습니다. WGP를 사용한 0.062kV TEM의 공간 분해능은 Cs 수차 보정기로 인해 158nm입니다. 새로운 분석용 고경사 홀더는 EDS 단층 촬영용으로 개발되었습니다. 이 홀더의 끝은 좁고 얇아서 생성된 X-ray가 EDS 단층 촬영을 위해 차단되지 않습니다. 이러한 부착물과 감지 영역이 2mm2인 대형 SDD를 사용하면 SDD1.1만의 입체각이 13sr 이상에 도달합니다. 우리의 EDS 검출 시스템은 단일 검출기로도 높은 공간 분해능과 높은 분석 계수율을 실현할 수 있습니다[XNUMX].
실험을 위해 두 종류의 샘플을 준비했습니다. 하나는 새로운 EDS 감지 시스템에서 음영 효과를 평가하기 위한 페인트 필름 샘플입니다. 다른 하나는 최첨단 반도체 소자 중 하나인 핀형 전계효과트랜지스터(FinFET)이다. 에폭시 수지로 매립된 대부분의 페인트 필름을 미세절단술로 200nm 두께로 슬라이스했습니다. 얇은 섹션은 3mm 직경의 얇은 바 그리드의 지지된 멤브레인에 장착되었습니다. 프로브 전류가 2pA인 300kV TEM을 사용하여 300D EDS 맵을 얻었습니다. TEM용 제어 PC에 설치된 단층 촬영 소프트웨어(TEMography, SYSTEM IN FRONTIER Inc.)에 의해 -60도에서 +60도까지 5도 증분의 틸트 시리즈 EDS 맵이 자동으로 획득되었습니다. 각 EDS 맵의 크기는 256 x 256 픽셀입니다. 픽셀 크기는 9.766nm/픽셀이었다. 획득 시간은 190분이었다. 실험에서 얻은 모든 EDS 맵은 EDS 분석기 소프트웨어(Analysis StationTM, JEOL Ltd.)에서 구현된 일괄 처리를 사용하여 동일한 조건의 광택 계수 맵에서 순 계수 맵으로 변환되었습니다. 재구성 절차의 시작 부분에서 HAADF-STEM 이미지의 틸트 시리즈를 fiducial marker로 정렬하고 요소 정보가 없는 3D 구조를 재구성했습니다. 이 재구성을 위한 3D 재구성 알고리즘은 SIRT(Simultaneous Iterative Reconstruction Technique)였습니다. TEMography 소프트웨어에서 구현된 일괄 처리를 사용하여 동일한 정렬 조건과 동일한 재구성 조건을 EDS 틸트 시리즈에 적용했습니다. 마지막으로 페인트 필름 샘플의 3D 요소 맵을 얻었습니다.
FinFET 샘플은 저속 다이아몬드 휠 톱으로 대충 절단했습니다. 샘플의 단면은 기계적 연마에 의해 얇아졌습니다. 마지막으로 샘플은 TEM 관찰을 위해 아르곤 이온 밀링 머신(Ion SlicerTM, JEOL Ltd.)으로 밀링되었습니다[16]. 직경 5 nm의 금 콜로이드 입자를 샘플 위에 떨어뜨려 기울기 계열의 정렬을 위한 기준 마커로 사용했습니다. TEM은 200kV의 가속 전압에서 작동되었다. EDS 요소 맵의 틸트 계열은 +64도에서 -64도까지의 틸팅 각도 범위에서 자동으로 획득되었습니다. 도 단계는 4도입니다. 각 EDS 맵의 크기는 256 x 256 픽셀입니다. 픽셀 크기는 1.953nm/픽셀이었다. 전류 밀도는 300pA였습니다. 단일 SDD(SDD120)를 사용하여 총 획득 시간은 약 2분이었습니다. FinFET 샘플의 재구성 절차는 페인트 필름 샘플과 동일했습니다.
FIG.3

- (b)에 표시된 두 개의 대형 SDD가 있는 300kV TEM(JEM-ARM300F, JEOL Ltd.).
- 감지 영역은 158mm입니다.2.
- EDS 단층 촬영용으로 개발된 고경사 분석 홀더. 홀더의 팁은 표준보다 좁고 얇아 생성된 X-ray를 차단하지 않습니다.
결과 및 토론
300kV TEM에 설치된 새로운 EDS 탐지 시스템에서 음영 효과를 평가하기 위해 페인트 필름 샘플의 EDS 단층 사진을 얻었습니다. HAADF 이미지와 3차원 원소 지도를 Fig. 4에 나타내었다. 산화티타늄 입자, 작은 실리카 입자, 작은 산화철 입자 및 탄소 수지로 구성된 도막 샘플은 그림 4에서 노란색, 녹색, 자홍색 및 파란색으로 표시하였다. (b) 각각. 페인트 필름 샘플의 EDS 맵에서 측정된 Ti Kα의 총 강도는 TEM에서 샘플 스테이지의 기울기 각도에 대해 표시됩니다. 그림 5에 표시된 빨간색, 파란색 및 녹색 점은 각각 SDD1, SDD2 및 SDD1+SDD2에 의해 감지된 총 강도에 해당합니다. 각 EDS 맵에서 산화티타늄 입자의 부피가 일정하기 때문에 정량적 EDS 분석 결과 Ti Kαmaps의 총 세기가 일정해야 한다. 그러나 SDD1과 SDD1+SDD2에서 감지된 강도는 음영 효과에 의해 약 -20도 정도 감소했습니다. 한편, SDD2에 의해 감지된 강도는 샘플 틸팅 범위에서 거의 일정하게 유지되었습니다. 이 결과는 기울임 축에 위치한 EDS 검출기가 샘플의 홀더와 그리드에서 X-선을 거의 차단하지 않았음을 나타냅니다. 이 단일 EDS 검출기를 사용하여 거의 그림자가 없는 EDS 단층 촬영 시스템을 실현했습니다.
그림자 없는 EDS 단층 촬영 시스템이 반도체 장치에 적용되었습니다. HAADF 이미지와 FinFET의 EDS 기울기 계열 맵은 그림 300에 표시된 6kV TEM으로 얻었습니다. HAADF 이미지의 흰색 점은 3D에서 정렬을 위한 기준 메이커로 사용된 금 나노 입자에 해당합니다. 재건 절차. Fig. 3에 나타낸 FinFET의 6차원 원소 맵은 SIRT 알고리즘을 사용하여 재구성하였다. 결과 지도에서 게르마늄, 티타늄, 텅스텐, 산소, 질소 및 규소가 검출되었습니다. 실리콘 기판 위의 게이트 전극의 3D 구조는 EDS 단층 촬영으로 명확하게 관찰되었습니다. 절연막에 해당하는 3D 질소 맵에는 여전히 노이즈가 있었습니다. 고감도 3mm158 SDD를 사용하여도 신호 대 잡음비가 높은 경원소의 2D 원소 분포를 관찰하려면 더 높은 전자 선량 또는 더 긴 획득 시간이 필요합니다. 그림 7은 획득한 3D 요소 볼륨 맵에서 추출한 X, Y 및 Z 방향에 수직인 슬라이스를 보여줍니다. Y-컷 슬라이스 맵의 위치는 Y-컷 슬라이스 맵 아래에 표시된 해당 Z-슬라이스 맵에서 노란색 선으로 표시됩니다. 게르마늄 스트레서(노란색), 텅스텐 전극(녹색) 및 실리콘 채널(파란색)은 Y-컷 슬라이스 맵(a)에서 명확하게 볼 수 있습니다. 그리고 채널과 전극 사이에 위치한 질소(magenta)를 3D elemental map에서 얻었다. 이러한 결과로부터 우리는 EDS 단층 촬영이 현대 반도체 장치의 3차원 원소 구조를 분석하는 데 유용하다는 결론을 내릴 수 있습니다.
본 연구에서는 TEM에서 디텍터 구성을 개선하여 EDS 단층촬영에서 그림자 효과를 제거하고자 하였다. 그러나 3차원 정량 분석을 위해서는 흡수 효과도 제거해야 합니다. 시료가 무거운 원소와 함께 가벼운 원소로 구성되어 있는 경우 EDS 단층 촬영에 의한 정량적 3차원 원소 분석에서 흡수의 영향이 심각했습니다. 우리는 EDS 단층 촬영에서 페인트 필름 샘플 자체에 의한 X선 흡수 효과를 평가했습니다. EDS 단층 촬영 데이터 세트는 200개의 SDD가 장착된 200kV TEM(JEM-F3, JEOL Ltd.)에 의해 각각 기울임 축과 샘플 홀더의 오른쪽에 위치했습니다. 티타늄, 철, 알루미늄, 실리콘, 산소 및 탄소의 3D 원소 맵은 페인트 필름 샘플의 EDS 틸트 계열 맵에서 재구성되었습니다. Cliff-Lorimer 방법을 이용하여 복셀별 복셀별 원소 조성비를 계산하였다. 그림 8에서 노란색 화살표로 표시된 3개의 이산화티타늄 입자의 115차원 조성비를 비교했습니다. 직경이 190nm인 입자의 315차원 조성비는 입자가 이산화티타늄이라는 사실과 일치했습니다. 그러나 직경이 3nm와 XNUMXnm인 입자의 산소 원자 백분율은 과소 평가되었습니다. 산소로부터의 X선은 시료 자체에 흡수된 것으로 생각된다. EDS 단층 촬영에서 높은 정확도로 XNUMXD 양적 원소 분포를 분석하려면 흡수 효과의 보정이 필요합니다.
FIG.4

- 검출 면적이 300mm158인 EDS 검출기가 장착된 JEM-ARM2F로 촬영한 페인트 필름 샘플의 HAADF 이미지.
- (a)에 표시된 샘플에서 재구성된 3D 이미지. 색상은 원자 종을 나타냅니다: 노란색(Ti), 녹색(Si), 자홍색(Fe) 및 파란색(c).
FIG.5

기울기 각도에 대해 플롯된 서로 다른 검출기 신호를 사용하는 페인트 필름 샘플의 Ti Kα 맵의 총 강도. 파란색 점, 빨간색 점 및 녹색 점은 Ti K에 해당합니다.α 각각 SDD1, SDD2 및 SDD1+SDD2의 신호에 의해 생성된 맵. SDD2에 의해 검출된 강도는 ET에 대한 샘플 틸팅 범위에 걸쳐 거의 일정했습니다.
FIG.6
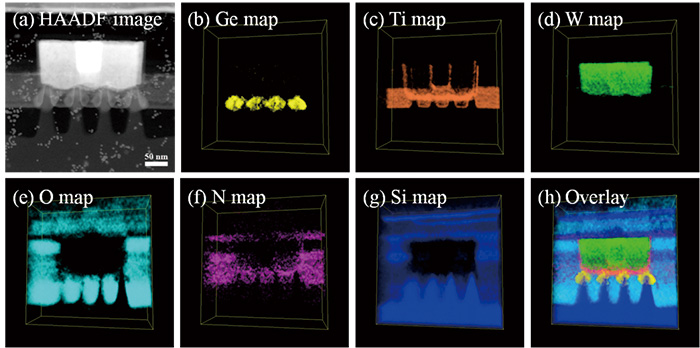
(a) 감지 영역이 300mm인 단일 대형 SDD가 장착된 JEM-ARM158F로 촬영한 FinFET 샘플의 HAADF 이미지2. 흰색 점은 기준 마커로 사용되는 금 나노 입자에 해당합니다. (b)-(h) 게르마늄, 티타늄, 텅스텐, 산소, 질소 및 규소 원자의 분포를 각각 보여주는 EDS 기울기 계열 맵에서 재구성된 (a)의 동일한 샘플의 3D 원소 맵. 샘플은 이온 밀링에 의해 희석되었습니다. 재구성된 볼륨의 크기는 (381, 377, 121) nm입니다.
FIG.7

EDS 단층 촬영을 사용하여 FinFET 샘플의 재구성된 3D 요소 볼륨 맵에서 추출한 Y-컷 및 Z-컷 슬라이스 맵. (a)와 (b)는 아래의 해당 Z-컷 슬라이스 맵에서 노란색 선으로 표시된 서로 다른 위치에 있는 Y-컷 슬라이스의 요소 맵을 보여줍니다. Z 컷 슬라이스는 웨이퍼 표면과 평행합니다. 게르마늄 스트레서, 텅스텐 전극, 실리콘 채널 및 기판은 각각 노란색, 녹색 및 파란색으로 표시됩니다.
FIG.8
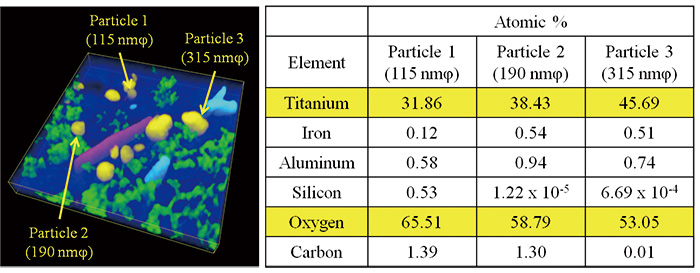
3mm SDD가 장착된 JEM-F200을 사용하여 얻은 EDS 단층 촬영으로 재구성한 페인트 필름 샘플의 100D 원소 맵2 감지 영역(왼쪽 그림). 노란색 화살표로 표시된 3개의 이산화티타늄 입자에 대한 2D 정량분석 결과를 오른쪽 표에 나타내었다. 입자 3와 XNUMX의 산소 조성비는 X선 흡수 효과로 인해 과소 평가된다. EDS 단층 촬영의 정량 분석에서는 흡수 효과를 무시할 수 없습니다.
요약
정량적인 3차원 원소 분석을 위해 열팽창성 미소구에 대한 새로운 EDS 검출 시스템을 개발하고 수차 보정된 300kV TEM에 시스템을 설치했습니다. 검출 시스템은 샘플 스테이지의 기울기 축(SDD2)과 기울기 축의 오른쪽(SDD1)에 배치된 서로 다르게 구성된 두 개의 EDS 검출기로 구성되었습니다. 이 SDD의 감지 영역은 158mm입니다.2. 또한 시료에서 생성된 X-ray가 차단되지 않도록 팁이 표준 홀더보다 좁고 얇은 고경사 분석용 홀더를 개발했습니다. 이 부착물과 함께 이 현미경을 사용함으로써 SDD1과 SDD2의 입체각은 각각 1.106sr과 1.108sr입니다. 페인트 필름 샘플의 EDS 단층 사진은 새로운 EDS 검출 시스템을 사용하여 얻었습니다. Ti K의 총 강도α 페인트 필름의 맵은 단층 촬영을 위한 샘플 기울기 범위에 걸쳐 거의 일정했습니다. 결과는 새로운 EDS 검출 시스템이 음영 효과 없이 EDS 단층 촬영을 얻을 수 있음을 나타냅니다. 새로운 EDS 감지 시스템을 사용하여 그림자 효과 없이 FinFET의 3D 원소 맵을 얻었습니다. 음영 효과는 EDS 감지 구성으로 제거할 수 있습니다. 흡수 효과의 보정은 EDS 단층 촬영에서 높은 정확도로 3차원 정량적 원소 분포를 분석하는 데 필요합니다.
참고자료
- D. Hisamoto, WC Lee, J. Kedzierski, E. Anderson, H Takeuchi, K Asano, TJ King, J. Bokor 및 C. Hu, "1998분의 1032미크론 시대를 위한 접힌 채널 MOSFET", IEDM Tech . Dig., (1034) pp. XNUMX-XNUMX.
- H. Tanaka, M. Kido, K. Yahashi, M. Oomura, R. Katsumata, M. Kito, Y. Fukuzumi, M. Sato, Y. Nagata, Y. Matsuoka, "펀치 및 플러그 프로세스를 사용한 비트 비용 확장 가능 기술 초고밀도 플래시 메모리용" VLSI 기술 심포지엄 회보, (2007) pp. 14-15.
- AM Cormack, "일부 방사선 응용 프로그램과 함께 적분에 의한 기능 표현", 차. 응용물리학, 34 (1963) 2722-2727 쪽.
- M. Hayashida, L. Gunawan, M. Malac, C. Pawlowicz 및 M. Couillard, "반도체 장치의 고정밀 전자 단층 촬영", 현미경 미세항문 . 21, 3(2015) pp. 1609-1610.
- B. Fu, M. Gribelyuk, L. Dumas, C. Fang, N. LaManque, L. Hodgkins 및 E. Chen, "반도체 웨이퍼 파운드리에서 NiSi 형성 관련 결함의 STEM 단층 촬영 및 STEM/EDS 분석 조합" , 현미경 미세항문 . 22, 3 (2016).
- K. Lepinay, F. Lorut, R. Pantel 및 T. Epicier, "3nm high K 금속 게이트 트랜지스터의 화학적 28D 단층 촬영: STEM XEDS 실험 방법 및 결과", 미크론 47 (2013) 43-49쪽.
- P. Burdet, J. Vannod, A. Hessler-Wyser, M. Rappaz 및 M. Cantoni, "이중 빔 FIB를 사용하여 레이저 용접된 NiTi-스테인리스 강선의 XNUMX차원 화학 분석", 액타 메이터., 61, 8(2013) 3090-3098쪽.
- A. Genc, L. Kovarik, M. Gu, H. Cheng, P. Plachinda, L. Pullan, B. Freitag 및 C. Wang, "나노 크기 입자의 3D 화학적 특성화를 위한 XEDS STEM 단층 촬영", 초현미경 131 (2013) 24-32쪽.
- B. Goris, L. Polavarapu, S. Bals, G. Van Tendeloo 및 L. Liz-Marzan, "XNUMX차원 형태 및 화학적 매핑을 통한 갈바닉 교체 모니터링", 나노레트 . 14, 6(2014) 3220-3226쪽.
- G. Möbus, R. Doole, B. Inkson, "분광 전자 단층 촬영", 초현미경, 96, 3-4(2003) 433-451쪽.
- Z. Saghi, X. Xu, Y. Peng, B. Inkson 및 G. Möbus, "에너지 분산형 X선 나노토그래피에 의한 텅스텐 프로브의 XNUMX차원 화학 분석", 적용 물리. 레트 사람. 91 (2007) 페이지. 25.
- L. Strueder, P. Lechner 및 P. Leutenegger, "실리콘 드리프트 검출기 - 새로운 실험의 핵심", 자연 과학 85, 11(1998) 539-543쪽.
- I. Ohnishi, K. Miyatake, Y. Jimbo, Y. Iwasawa, M. Morita, T. Sasaki, H. Sawada 및 E. Okunishi, "수차 보정 300을 위한 2016개의 초대형 SDD의 초고효율 X선 검출 시스템 kV Microscope", Proceedings of Microscopy & Microanalysis 22, 3, S2016(318) pp. 319-XNUMX.
- CSM Yeoh, D. Rossouw, Z. Saghi, P. Burdet, RK Leary 및 PA Midgley, "EDX 단층 촬영의 어두운 면: 3D 원소 신호 분석을 돕기 위한 모델링 검출기 쉐도잉", 현미경 미세항문. 21, 3(2015) 759-764쪽.
- Pierre Burdet, Z. Saghi, AN Filippin, A. Borrás 및 PA Midgley, "양적 EDX-STEM 단층 촬영을 위한 새로운 3D 흡수 보정 방법", 초현미경 160 (2016) 118-129쪽.
- A. Yasuhara, "이온 슬라이서(박막 시편 준비 장비) 개발", 전일뉴스 40 (2005) 46-49 쪽.
