
FEATURE
원활한 관찰 및 분석 가능
FIB 처리 기능을 더욱 강화했습니다. 새로운 광학 컬럼으로 SEM 이미징이 크게 향상되었습니다. 연동 기능으로 조작성이 향상되었습니다.
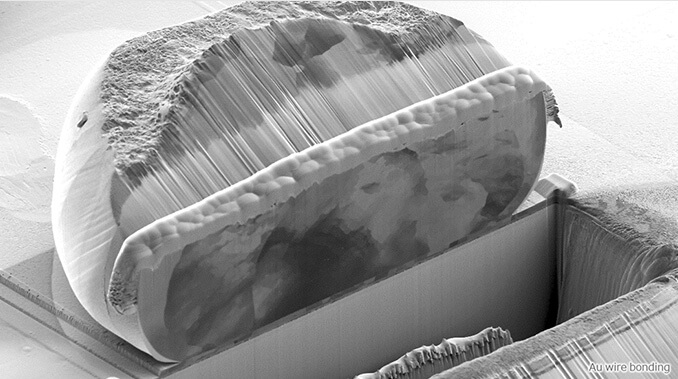
FIB : 더욱 강화된 처리 능력
- ・향상된 제어 시스템
벡터 스캔 시스템은 임의의 형상을 원활하게 처리할 수 있습니다.
간단한 3차원 관찰 및 분석이 가능합니다. - ・대형 이온빔 전류 최대 90nA
시료의 고속 처리가 가능합니다.
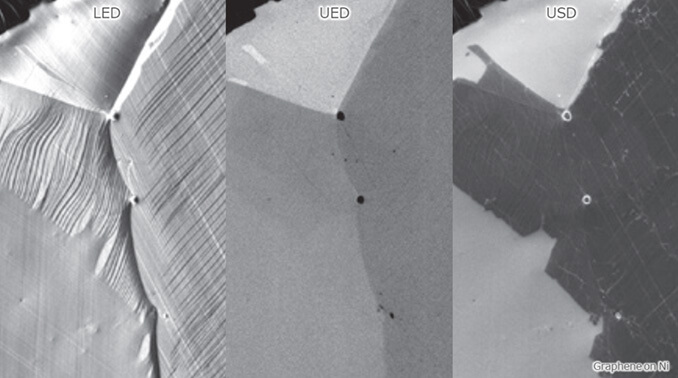
SEM : 향상된 이미징 성능
- ・낮은 가속 전압에서 고해상도
하이브리드 원추형 대물 렌즈와 GENTLEBEAM™의 조합은 낮은 가속 전압(1.6kV에서 1nm)에서 높은 해상도를 달성합니다. - ・다양한 이미지 획득
새로 추가된 UED 및 USD 검출기는 속성, 화학 조성 및 결정 구조에 대한 정보가 포함된 다양한 SEM 이미지를 수집할 수 있습니다. - ・큰 프로브 전류에서 높은 분해능
"in-lens Schottky 전자총"과 ACL(Aperture Angle Control Lens)의 조합으로 큰 프로브 전류에서도 높은 분해능을 유지하여 빠른 분석이 가능합니다.
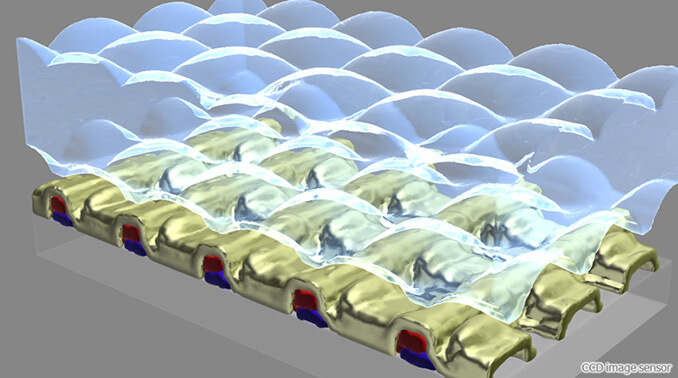
3차원 관찰 및 분석
- ・안정적인 자동 측정
Slice and View 시스템(JIB-4700F의 표준 구성 요소)은 처리, 관찰 및 분석의 자동 반복을 가능하게 합니다. - ・쉬운 재건
반복된 단계 후에 3D 재구성 소프트웨어(IB-3STKV)*에 의해 연속적으로 획득된 데이터로부터 67020D 재구성 이미지가 획득됩니다.
신청
FIB-SEM이 제공하는 다양한 솔루션
단면 시편 준비, TEM 시편 준비, 3D 관찰, 3D EDS 분석, 3D EDSD 분석, 미세 형상 가공
교차 구역
JIB-4700F Multi Beam System을 사용하면 보호 필름 준비, 표본 밀링에서 단면 관찰 및 분석에 이르기까지 원활한 작업이 가능합니다. FIB 컬럼은 대전류 Ga 이온 빔(최대 90nA)으로 처리할 수 있습니다. 이 대전류 처리는 대면적 표본 준비에 특히 효과적입니다.
TEM 샘플
JIB-4700F와 매니퓰레이터 시스템의 조합으로 원활한 TEM 시편 준비가 가능합니다. 후방 산란 전자 검출기를 사용하면 고해상도 SEM 이미지로 FIB 밀링 진행 상황을 관찰할 수 있습니다. JIB-4700F는 TEM 시편 준비를 위한 최종 밀링 끝점 감지와 같은 작업 효율성을 향상시킵니다.
3D-EDS 분석
3D-EDS*는 시료 표면에 수직인 입사 이온 빔을 사용한 FIB 밀링과 SEM 프로브를 사용한 EDS 분석의 자동 직렬 단계를 가능하게 합니다. 빠른 EDS 분석을 허용하는 큰 프로브 전류에서 높은 분해능.
3D-EBSD 분석
최적으로 배치된 EBSD 검출기*는 스테이지 이동 없이 처리 및 분석이 가능합니다. 이 기능은 짧은 시간에 데이터 수집의 높은 위치 정확도를 제공합니다.
*옵션 첨부