JBX-8100FS 전자빔 리소그래피 시스템 개발
절뉴스 Vol.53 No.10
아이다 유키노리
SE 사업부, JEOL Ltd.
Electron Beam Lithography System(이하 EBL)은 사용자가 설계한 데이터를 실리콘 기판이나 포토마스크 블랭크에 재현할 수 있는 제품입니다. 전자빔의 모양은 용도에 따라 달라집니다. 스폿형 전자빔(이하 SB)이 이 보고서에 설명되어 있습니다. SB는 원형 직경이 수 nm인 전자빔이기 때문에 10nm 이하 크기의 패턴 가공이 가능하다. 레이저 측정 시스템을 통합한 고정밀 스테이지 포지셔닝 기술로 전자 빔의 위치를 수정하여 스테이지 정지 위치의 오차를 보정할 수 있습니다. 기존에 이러한 기능을 갖춘 SB의 적용은 주로 차세대 반도체 장치의 연구 개발이었습니다. 그러나 최근에는 다양한 통신기기 및 센서의 생산에 활용되면서 SB에 대한 전세계적인 수요가 증가하고 있다. 응용 분야는 자동차 충돌 방지 시스템에 사용되는 센서 생산에서 4세대 통신 시스템(4G)의 통신 허브에 사용되는 분산 피드백(DFB) 레이저에 이르기까지 다양합니다. 이러한 요구를 충족시키기 위해 신제품 JBX-8100FS가 개발되었습니다. 이 보고서에서는 JBX-8100FS 시리즈를 소개합니다.
개요
사용자는 CAD 등을 사용하여 패턴 데이터를 생성합니다. 이 데이터는 EBL 시스템에 의해 기판 재료에 복제되어 나노 가공이 가능합니다. 반도체 소자 제조의 목표 중 하나가 제품을 더 작게 만드는 것이기 때문에 반도체 제조에 사용되는 장비 제조사는 더 작은 패턴 크기를 제공할 수 있는 장비를 개발해야 합니다. 예를 들어 DFB 레이저 생산을 위해 0.1nm 이하의 고정밀도로 피치를 제어할 필요도 있습니다. 이는 매우 정확한 포지셔닝이 필요함을 의미합니다. 나노 임프린트 템플릿 제작 연구를 위해서는 위에서 설명한 정확도 외에도 기판 내에서 높은 위치 정확도를 달성하는 것도 필요하다. 또한 밀리미터파 장치에 사용되는 트랜지스터를 제작하려면 사전 제작된 재료에 높은 정확도로 패턴을 오버레이해야 합니다. 여기에서 알 수 있듯이 정확도 요구 사항은 생산되는 장치 유형에 따라 다릅니다. JBX-8100FS(그림 1)는 이러한 다양한 요구를 충족시키기 위해 개발되었습니다.
JBX-8100FS(표 1)의 사양에는 최대 가속 전압 100kV, 최대 스캔 속도 125MHz, 쓰기 가능 영역 150mm × 150mm, 레이저 측정 분해능 0.6nm가 포함됩니다. 높은 처리량 모드 및 고해상도 모드의 성능 사양이 표시됩니다. 이 시스템은 제조에서 R&D에 이르기까지 광범위한 요구를 처리할 수 있습니다. 높은 처리량 모드의 성능에는 최대 시야 크기 1000μm, 최소 빔 직경 5.1nm, 데이터 증분 0.5nm, 필드 스티칭 정확도 ±20nm 이하, 오버레이 정확도 ±20nm 이하, 최소 선폭이 포함됩니다. 12nm 이하, 전류 드리프트 0.2%pp/h 이하, 빔 위치 드리프트 60nm pp/h 이하. 이에 비해 고해상도 모드에서 성능에는 최대 필드 크기 100μm, 최소 빔 직경 1.8nm, 데이터 증분 0.05nm, 필드 스티칭 정확도 ±9nm 이하, 오버레이 정확도 ±9nm 이하, 최소 선폭 8nm 이하, 전류 드리프트 0.2%pp/h 이하, 빔 위치 드리프트 10nmp-p/h 이하. 또한, 통상 운전시의 소비 전력은 3kVA이므로, 러닝 코스트 면에서도 매력적인 기기입니다.
Fig.1 JBX-8100FS 외관

전원 공급 장치, 냉각수 순환기 및 건식 펌프를 제외한 모든 장치가 패널 내에 포함되어 있습니다.
표 1 JBX-8100FS 주요 사양(엔트리 모델)
| 항목 | JBX-8100FS(G1) 엔트리 모델 |
|---|---|
| 가속 전압 | 100 kV |
| 필드 크기 | 1,000µm × 1,000µm(HT), 100µm × 100µm(HR) (HT; High Throughput 모드 / HR: 고해상도 모드) |
| 최소 데이터 증분 | 0.5nm(HT), 0.05nm(HR) |
| 스캔 속도 | 125 MHz |
| 스캔 속도 변조 | 256 등급/해상도 0.05nsec ~ |
| 포지셔닝 DAC / 스캐닝 DAC | 20 비트 / 14 비트 |
| 빔 직경 | 5.1nm(HT), 1.8nm(HR) |
| 최소 선폭 | <12nm(HT), <8nm(HR) |
| 필드 스티칭 정확도 | ≦ ± 20nm(HT), ≦ ± 9nm(HR) |
| 오버레이 정확도 | ≦ ± 20nm(HT), ≦ ± 9nm(HR) |
| 빔 전류 안정성 | 0.2%pp/h(@2nA, HT) |
| 빔 위치 안정성 | ≦ 60nmp-p/h(@2nA/HT), ≦ 10nm/hp-p(@2nA/HR) |
| 운영체제 | Linux, ('데이터 준비 프로그램'은 Windows 8.1 및 10에서 작동 가능) |
| 쓰기 영역 | 150 mm × 150 mm |
| 기판 크기 | 전체 6인치 웨이퍼, 8인치 웨이퍼 적재 가능, 작은 조각, 6인치 마스크 |
| 최대 스테이지 속도 | 25mm / 초 |
| 레이저 측정 해상도 | 0.6 nm의 |
| 전기 요구 사항 | 3kVA(메인 콘솔 2kVA, cwc 1kVA, 일반) |
다른 옵션으로는 12카세트 자동 로딩 시스템과 전환 가능한 가속 전압(50kV/25kV)이 있습니다.
성능 테스트 결과
JBX-8100FS의 최소 선폭, 필드 스티칭 정확도, 오버레이 정확도 및 필드 면내 치수 정확도에 대한 성능을 측정했습니다.
최소 라인 너비
JBX-8100FS의 리소그래피 성능을 평가하기 위해 실리콘 기판에 50nm 두께의 ZEP520A 레지스트(ZEON Corp.)를 도포하고, 빔 전류 100pA, 최소 빔 직경 1.8nm의 조건에서 기록을 수행하였다. 8nm 이하의 최소 선폭이 보장됩니다. 이번에는 더 미세한 구조를 얻기 위해 특수 개발이 사용되었습니다. 저온 현상은 강화된 구조를 얻기 위한 방법으로 일반적으로 알려져 있다[1]. ZEP520A 레지스트는 2.8°C의 온도에서 현상되었으며, 이를 통해 4.2nm의 최소 선폭을 입증하는 데이터를 얻을 수 있었습니다(그림 2).
Fig.2 최소 폭 선의 단면 이미지(×200k)
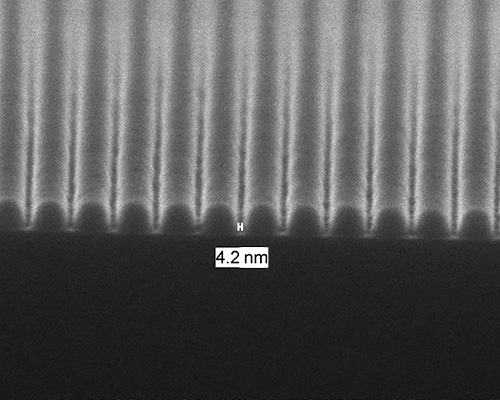
두께 520nm의 ZEP40A(ZEON 제품)를 사용하면 저온 효과를 사용하여 4.2nm의 선폭을 얻을 수 있습니다.
필드 스티칭 정확도
JBX-8100FS는 레이저 빔 제어(이하 LBC)라는 스테이지 위치 보정 시스템을 활용하여 매우 정확한 위치 보정을 제공합니다. 또한 JEOL의 독자적인 소재 왜곡 보정과 편향 왜곡 보정을 추가하여 정확도를 보장합니다. 필드 스티치 정확도를 측정하기 위해 광학 좌표 측정 시스템을 사용했습니다. 각 처리 필드의 모서리에 "L" 마크를 배치하고 필드의 4×4 레이아웃을 처리했습니다. 필드 사이의 교차점에서 L자형 마크의 좌표를 측정하고 위치 정확도를 평가했습니다. 1000μm 영역에 대한 결과가 여기에 보고됩니다. 사양은 ±20nm 이하의 정확도를 보장합니다. 얻은 실제 결과는 +11.5 nm / -9.8 nm였습니다(그림 3(a)). 필드 모서리에 배치된 해상도 8nm의 Vernier 패턴도 육안으로 확인되었으며 유사한 성능 결과를 얻었습니다(그림 3(b)).
Fig.3 필드 스티치 정확도 측정 결과
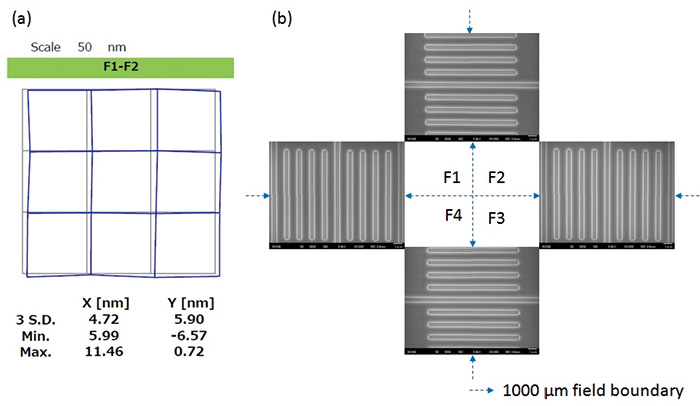
(a) 측정 영역은 4mm 간격(4mm×10mm 영역 정의)의 30×30 점 배열로 정의하고 필드 스티치 정확도를 측정했습니다. 보증값은 ±20nm 이하이지만 실제로 얻은 결과는 +11.5nm / -9.8nm(X/Y)였습니다.
(b) 같은 방법으로 버니어 패턴의 해상도 8nm의 SEM 관찰 결과를 얻었고, 유사한 값이 관찰되었다.
오버레이 정확도
SB의 특징 중 하나는 이미 다른 패턴이 기록된 기판에 패턴을 직접 기록할 수 있다는 것입니다. EBL 시스템에는 처리 중인 재료에 생성된 정렬 마크를 감지하고 좌표를 결정할 수 있는 마크 감지 기능이 장착되어 있습니다. 그려지는 패턴의 위치가 얼라인먼트 마크의 좌표를 기준으로 기록되면 쓰기를 수행할 때 편차를 계산하고 수정할 수 있습니다. 이 성능을 평가하기 위해 EBL을 사용하여 첫 번째 레이어와 두 번째 레이어를 모두 처리했습니다. 쓰기 영역은 30mm×30mm(4mm 간격으로 4×10포인트) 3mm 이내의 한 곳에 3mm×4mm 영역(4mm 간격으로 1×30포인트)을 중첩하여 측정했다. mm × 30mm 쓰기 영역과 오버레이 정확도를 측정했습니다. 보장된 성능은 ±20 nm 이하이며 실제 결과는 +4.1 nm / -6.7 nm였습니다(그림 4(a)). 유사하게, 8 nm의 해상도를 가진 Vernier 패턴의 측정 결과는 중첩이 X와 Y 방향 모두에서 거의 완벽하게 중앙에 있음을 보여주었습니다(그림 4(b)).
Fig.4 오버레이 정확도 측정값
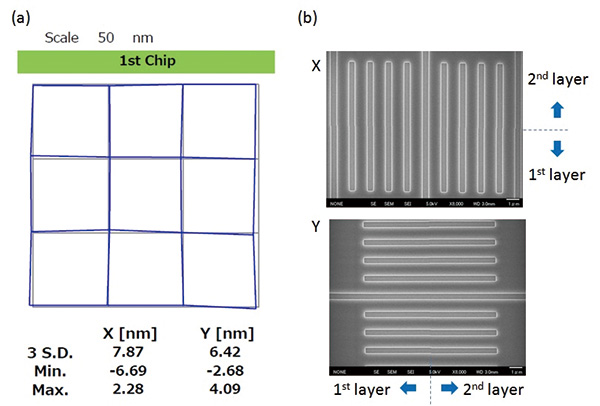
(a) 쓰기 영역은 4mm 간격(4mm × 10mm 영역 정의)의 30 × 30 점 배열로 정의되었습니다. 측정 영역은 4mm 간격(4mm x 1mm 영역 정의)의 3 x 3 점 배열로 정의되었으며 오버레이 정확도가 측정되었습니다. 보증값은 ±20nm 이하이지만 실제로 얻은 결과는 +4.1nm / -6.7nm(X/Y)였습니다.
(b) 같은 방법으로 버니어 패턴의 해상도 8nm의 SEM 관찰 결과를 얻었다. X 및 Y 방향 모두 패턴이 거의 중앙에 중첩되었습니다.
현장 내 CD(Critical Dimension) 균일성
DFB 레이저에 필요한 것과 같은 격자 드로잉을 수행하고 선폭의 정확도를 결정했습니다. 1000μm 필드의 중앙과 각 모서리에 라인 앤 스페이스 패턴을 배치했습니다. 선폭 100nm, 피치 200nm의 기입을 행했다. 결과는 최대 1.1nm 및 최소 100.6nm에서 99.5%pp의 정확도를 보여줍니다(그림 5).
그림 5 필드 내 임계 치수 균일성
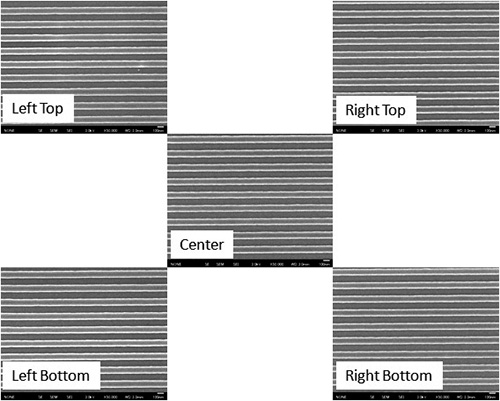
1000μm 필드의 중앙과 각 모서리에 라인 앤 스페이스 패턴을 배치했습니다. 선폭 100nm, 피치 200nm의 기입을 행했다. 결과는 최대 1.1nm 및 최소 100.6nm에서 99.5%pp의 정확도를 보여줍니다.
안정
안정성은 기본적으로 24시간 운영되는 EBL의 중요한 성능 요소입니다. 이 시스템에 JEOL 전용 공조 장치와 JEOL EMI 카운터 유닛을 장착하는 것도 가능하므로 더 나은 안정성을 얻을 수 있습니다. 100nA의 전류를 사용하여 2kV High Throughput 모드에서 측정한 결과 전류 드리프트는 0.08%pp/h, 빔 위치 드리프트는 X 방향으로 9.5nmp-p/h, 10.8nmp-p/h로 나타났습니다. h를 Y 방향으로 이동합니다(그림 6).
그림 6 안정성

안정성은 1kV 고처리량 모드에서 100시간 동안 측정되었습니다. 2nA의 전류를 사용했을 때 전류 드리프트는 0.08%pp/h, X 방향의 위치 드리프트는 9.5nmp-p/h, Y 방향의 위치 드리프트는 10.8nmp-p/h였다.
처리량
SB는 빔 프로파일이 작기 때문에 가변형 EBL에 비해 처리 시간이 길어지는 경향이 있습니다. 상술한 바와 같이, 최근에는 이것들이 제조에 이용되고 있기 때문에, 디바이스 개발의 초점은 스루풋 향상이었다. 리소그래피 시스템의 처리량을 결정하는 요소에는 스테이지 이동 시간, 이동 후 스테이지 정착 시간, 보정 시간, 데이터 전송 시간, 전기 시스템 정착 시간 및 빔 노출 시간이 포함됩니다. JBX-8100FS로 달성한 이러한 요소의 개선 사항은 아래에 설명되어 있습니다.
- 스테이지 이동 시간
이것은 스테이지 이동의 최대 속도에 따라 다르지만 짧은 거리의 경우 가속도 매우 중요합니다. 이는 다양한 매개변수의 최적화를 통해 10%~20% 향상되었습니다. - 데이터 전송 시간
쓰기 전 그림 데이터 전송에 필요한 시간입니다. 이것은 기존 시스템에 필요한 시간의 1/3에서 1/5로 개선되었습니다. - 부편향 증폭기 안정화 시간
데이터 전송에서 쓰기 시작까지 필요한 시간입니다. 전송 시간과 비교하면 이제 무시해도 될 만큼 짧습니다. - 빔 노출 시간
스폿 빔을 사용한 단일 스폿에 대한 빔 조사 시간은 다음 식으로 주어집니다.

t: 빔 조사시간[sec], Q: 저항 감도 [C/cm2], p: 샷 피치 [cm], I: 빔 전류 [A]
JBX-8100FS에서 최소값은 t 8nsec(주파수로 표현하면 125MHz)입니다. 기존 시스템에 비해 XNUMX배 이상의 속도로 스캐닝이 가능합니다.
상술한 개선의 결과, 전체 기판 표면의 약 30%를 덮는 기입 영역을 갖는 패턴에 대해 총 기입 시간의 40% 내지 10% 개선이 가능하다.
전력 소비
시스템을 구매한 후 중요한 진행 요소는 운영 비용이 됩니다. 특히 EBL 시스템의 경우 안정적인 기능을 위해서는 리소그래피를 하지 않는 경우에도 동일한 전력을 지속적으로 공급할 필요가 있다. JBX-8100FS의 전기 장치 및 전원 섹션은 컴팩트하게 설계되어 정상 작동 시 전력 소비를 3kVA로 줄입니다. 이를 통해 기존 시스템에 필요한 전력의 약 1/3만 사용하여 시스템을 작동할 수 있습니다.
요약
반도체 장치의 R&D 및 생산은 광범위한 응용 분야를 다루며 필요한 기능과 정밀도는 다양합니다. JBX-8100FS는 모든 분야에서 고정밀, 고속으로 사용이 가능하면서도 소비전력을 절감할 수 있는 전자빔 노광 시스템으로 개발되었습니다. 향후 계획에는 처리량의 추가 개선과 기판 처리 방법 개선이 포함됩니다.
감사의 글
이 제품 개발에 조언과 도움을 주신 모든 프로젝트 구성원에게 진심으로 감사드립니다.
참고자료
- T. Okada, J. Fujimori, M. Aida, M. Fujimura, T. Yoshizawa, M. Katsumura 및 T. Iida: "ZEP520A의 냉간 현상에서 향상된 해상도 및 그루브 폭 시뮬레이션" J. Vac. 과학. 기술. B 29 (2011) 021604.
